導体抵抗システムでは微小クラック等を抵抗値の変化により判定する事が可能です。
リフロー耐熱試験ではベーク・吸湿・リフローまでの試験を行います。
熱抵抗測定ではLSIを基板に組み込む際の判断材料として適用していただけます。
| 信頼性評価事例 |
| 温度サイクル連続抵抗モニター評価 --T/Cによる導通抵抗の変化をリアルタイムで測定-- |
|
 |
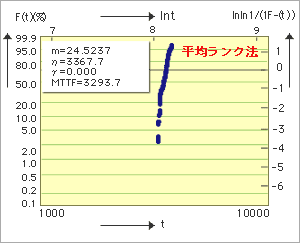 |
| 導体抵抗評価事例 |
| 弊社では導体抵抗評価システム(AMR)を取り入れ、TC試験機と連動させることで半導体部品などの接合部に発生する微小クラックをより正確に捉える事が可能です。 |
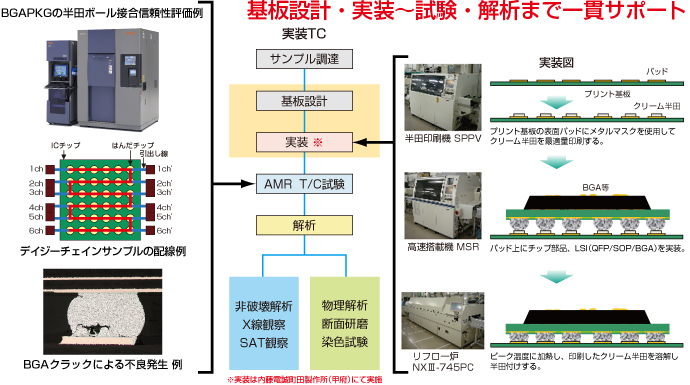 |
| リフロー耐熱性試験 |
|
| 耐熱性試験 | ||||||||
| リフロー耐熱試験では実際の実装工程の環境を再現しリフローを行う事により試験体のリフロー耐熱性、不良傾向及び不良原因を確認する事ができます。 | ||||||||
|
| 不具合イメージ例:PBGA(Plastic Ball Grid Array) |
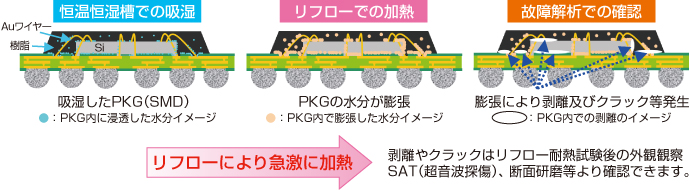 |
| 熱抵抗測定 逆バイアス発熱法(製品サンプルで測定可能) |
| 【熱抵抗とは】 | 温度の伝えにくさを表す値で、発熱量あたりの温度上昇量を表したもの。 |
| ・熱抵抗測定器(TRM-7110A)を独自に開発 |
| 逆バイアス発熱法を使ってTEGサンプル、製品サンプル※の熱抵抗測定が可能。 JEDEC規格に準拠した測定を行うことができ、風洞などの測定環境も取り揃えております。 |
| ※サンプル仕様によっては測定出来ない可能性があります。 |
| ・基板作成から熱抵抗測定まで一貫したサポートをご提供 |
| 発熱検証、基板設計・実装、熱抵抗測定までサンプルの熱抵抗測定の全てをサポートすることができます。 |
| ※サンプル仕様によっては測定出来ない可能性があります。 |
熱抵抗測定システム:TRM-7110A(当社開発システム)
|
| 測定項目 | θja (ジャンクション‐周囲温度間抵抗) ψjt (ジャンクション‐PKG top間熱パラメーター) ジャンクション温度=チップ温度 |
| 測定環境 | 風洞:JEDEC規格準拠(JEDEC51-2、51-6) 周囲温度:常温 風速:0~4m/sec |
| 測定サンプル | ダイオード温度特性のとれるPKG 発熱実験を行い、測定可能か検証をいたします |
| 加熱用出力電源 | 最大出力電流:2A 最大出力電圧:5V |
| 測定Ch数 | 2ch |
| 測定に必要な情報 | パッケージ外形図 ピン端子表 チップ内ブロック図(発熱エリアを検証するため) |
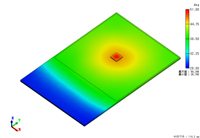 |
オプション:熱シミュレーション対応可能 |
| 【メリット】 ■熱抵抗実測結果の検証 測定した熱抵抗が妥当な値であるかを検証できます。 ■熱抵抗測定のパラメーター変更における影響の検証 樹脂変更、ステージ露出のはんだ有り無しなどの影響に ついて提案できます。 |
| ハイパワー恒温恒湿試験機(ARS-1100-J) |
| より厳しさを求められる環境試験(車載用部品、モバイル製品など)の試験要求にお応えします。 弊社ではハイパワー恒温恒湿試験機を導入し、幅広い温湿度環境下での耐性試験に対応可能です。 |
|||
|
試験例 |
ISO16750-4 温度プロファイル例 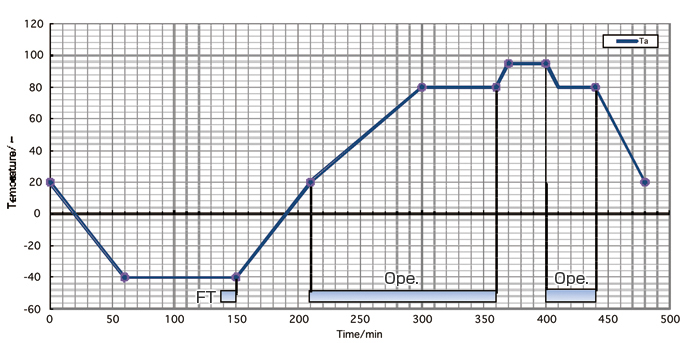 |
特徴 |
1.幅広い温湿度制御範囲 2. 95℃/98%rhでの安定した温湿度制御を実現 3. 優れた温度上昇・下降性能 4. 処理量拡大を実現した大型槽 |
| 冷熱衝撃装置(TSA-73EH-W 300℃タイプ) |
| 次世代パワー半導体向け300℃仕様冷熱衝撃装置を新たに導入。 幅広い温度領域での環境試験に対応可能です。 |
|||
|
特徴 |
幅広い温度制御範囲 低温側:-70℃~0℃ 高温側:+300℃~+60℃ ⇒従来機(Max+200℃) 高温度域の拡大制御が可能です。(テストエリア雰囲気) 高テストエリア内寸:W410×H460×D370mm |
次世代パワー半導体と試験要求 |
次世代パワー半導体の需要拡大 次世代パワー半導体試験要求 |